- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
斜入射干涉检测大口径碳化硅平面反射镜
1 引 言
近年来,在天文光学、空间光学、大型激光装置等高科技领域,大口径光学系统的应用越来越广泛而深入。考虑其对热稳定性等特点的特殊要求,空间遥感相机常选用SiC作大口径反射镜的制作材料[1-2];然而其口径大、硬度高等特点给高精度加工与制造带来很大的难度[3],同时对相应的检测技术也提出了很高的要求。目前,大口径光学平面的检测方法主要有直接测量法[4]、刀口阴影法、子孔径拼接法[5]、五棱镜扫描法[6]、瑞奇-康芒法[7-8]以及斜入射法[9]等。使用大口径干涉仪[4]可直接测量大口径SiC平面反射镜三维分布,这种方法简单直观;但大口径干涉仪的成本高,制造周期长,而且由于SiC反射镜反射率高,普通干涉仪在正入射测量时获得的干涉图对比度差,从而影响测量精度。刀口阴影法能够根据观察的阴影图形状确定波面局部误差的方向和位置,灵敏度很高;但是这种方法的测量结果在很大程度上与检验者的主观因素有关,难以对平面镜的面形进行定量测量。子孔径拼接法[5]是采用小口径干涉仪分多次分别检测大口径光学镜面的各个部位,然后依次将这些子孔径的参考面拼接到同一个参考面上来恢复出全口径波面的完整面形;这种方法可以获得更高的空间分辨率,但是检测过程较长,操作复杂,而且测量精度需要进一步提高。五棱镜扫描法装置中采用了高精度的自准直仪[6],自准直仪的出射光束经扫描五棱镜折转90°后由待测平面反射回去,由该装置可以测量出待测平面的面形微分,从而实现对待测平面的面形测量;该方法精度较高但测试时间较长,因此对测试环境要求较高。瑞奇-康芒法在数字球面干涉仪上进行,需要使用参考球面和大口径的反射球面[7-8];这种方法数据处理复杂,且干涉腔很长,容易对面形的测量精度造成一定影响。斜入射法[10]只需要将被测元件倾斜放置并引入反射平面经过简单调整即可以直接在斐索干涉仪上实现待测平面的面形测试。本文在本课题组研制的国内首台600 mm口径干涉仪上采用斜入射测试方法对630 mm口径的SiC平面反射镜进行了面形测试与评价。
2 原 理
采用干涉仪斜入射法检测大口径平面反射镜的基本原理如图1(a)所示。由斐索干涉仪标准参考平面A透射的波面经待测平面C反射,垂直入射到标准反射平面B后按原光路返回,与参考波面干涉形成干涉条纹。斐索干涉仪的测试结果表示被测光学平面相对于干涉仪的标准参考平面的偏差,即测试结果中包含了干涉仪的系统误差。当被测平面与参考平面的面形精度接近时,只有采用绝对检验方法,才可以得到被测平面的真实面形分布。斜入射测试条件下绝对检验的原理如图1所示。

首先如图1(b)所示,在一个标准的斐索干涉测试结构中测出A面与B面的干涉波面数据:
M1(x,y)=A(x,y)+B(-x,y) , (1)
然后如图1(a)所示把待测平面C放入干涉光路中,使得待测平面的光轴与干涉仪光轴成α角。注意此时C将B关于y轴翻转了180°,测量可得:

当x=0时,联立式(1)、(2)即可得到C平面x方向对称轴上的y方向面形分布:

同理当y为0时,联立式(1)、(4)即可得到C平面y方向对称轴上的x方向面形分布:
![]()
由此可见,此方法的优点在于只要采用3次测量就能得到两个相互垂直的直径方向上的绝对面形分布。
3 实 验
采用本课题组自主研制的大口径近红外相移平面干涉仪斜入射测量了630 mm口径的SiC反射镜。该干涉仪采用卧式斐索型结构,工作波长λ=1 055 nm。有效口径(600 mm)内参考平面与反射平面构成的空腔精度指标PV值达到了0.067λ,RMS值为0.010λ。选择反射率约为0.04的600 mm口径微晶反射镜作为反射平面,以45°作为入射角按图1(a)所示进行测量,所得的干涉图如图2(a)所示。斜入射测试的三维面形分布如图2(b)所示,被测SiC反射镜的面形斜入射测量结果为PV=0.098λ,RMS=0.014λ。

从上述测试结果可以看出,被测件的面形精度已经与干涉仪系统的空腔精度非常接近,测试所得的波面结果并不能精确反应被测件表面的真实信息。因此需要采用斜入射绝对检验方法测量该SiC反射镜多条垂线方向上的绝对面形分布。首先测量参考平面A和反射平面B构成的空腔,其中心垂线的测量结果如图3所示, PV =0.049λ,RMS=0.013λ。得到空腔中心垂线方向的结果将作为系统误差在斜入射测得的结果中扣除。

为保证斜入射检测过程中参考平面A与反射平面B参与干涉的垂线空间位置始终与空腔测试时一致,在反射平面B上用两根交叉的细线标记出其中心位置。将SiC反射镜、反射平面B按图1(a)所示的斜入射测试光路依次摆放,调整它们的位置使反射平面B的中心及SiC反射镜的中心与标记的中心重合,测量可得此波面中央垂线方向的波面分布,如图4所示,PV=0.041λ,RMS=0.010λ。

从以上得到的中央垂线方向的斜入射结果中扣除系统误差可以得到SiC反射镜中央垂线方向的绝对检验结果。如图5所示,PV=0.061λ,RMS=0.014λ。
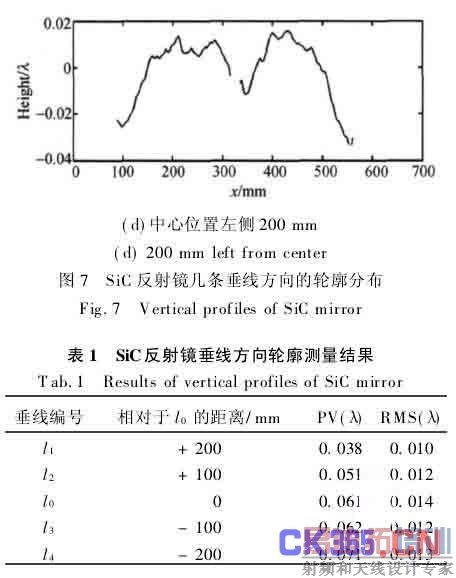
现保持A,B平面不动,沿C平面放置方向保持α角不变平移C平面到其他位置调出干涉图,重复以上步骤可实现C平面其他垂线方向的绝对面形测量。测量得到的5条垂线在SiC反射镜上的位置分布情况如图6所示。其中l0为中心垂线,5条垂线等间距(100 mm)分布。

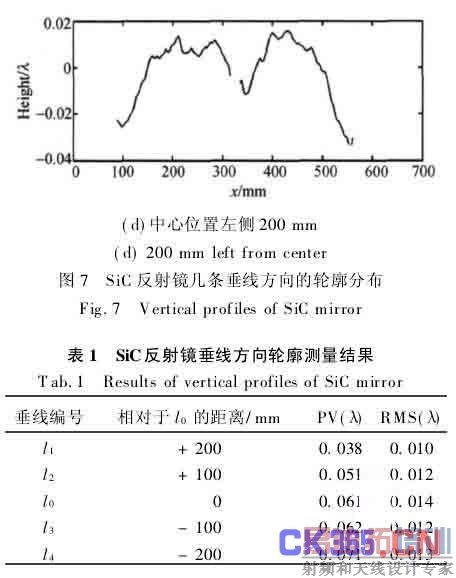
分别得到SiC反射镜表面其他垂线上的绝对面形分布及结果如图7及表1所示:
4 讨 论
4.1 空间分辨率
对于同一被测件,斜入射干涉图在横向被压缩,所得被测件波面的横向空间分辨率降低。如图1(b)所示,斜入射测量得到的波面沿被测件倾斜方向压缩,压缩比为cosα,即
L=LC·cosα. (6)
由(6)式可知,α角的增大会导致斜入射干涉图横向分辨率损失变大,获取的波面数据减少。但α角太小则会对斜入射干涉光路造成遮挡,影响测试。因此实际测量时应合理选择α值,满足测试空间分辨率的要求。另外由于斜入射绝对检验是针对垂线方向的绝对面形测量,所以α角引起的横向分辨率的改变对斜入射绝对检验结果没有影响。
4.2 干涉图比例因子
干涉图比例因子[11](Interferogram ScaleFactor,ISF)反应了干涉图所代表的被测波前与实际被测物体表面面形信息的关系。斐索干涉仪正入射测试时,干涉图比例因子为0.5。斜入射测量装置的干涉图比例因子为:

测量斜入射角度α计算出干涉图比例因子可以由测试波面估算出待测平面的面形。当α=60°时,斜入射的干涉图比例因子与正入射时相同。
4.3 干涉条纹对比度
根据干涉条纹对比度的定义式,两次反射斜入射的干涉条纹对比度C可以表示为:

式中RA,RB分别为A,B正入射时的光强反射比,RC(α)是入射角为α时C的光强反射比,均可以根据Fresnel公式得到。可见当平面A,B材料性质确定后,条纹对比度随斜入射角α下被测件C的反射率发生变化。图8给出了当A、B、C皆为未镀膜的光学平面时干涉条纹对比度与入射角之间的关系。当测量未镀膜光学平面时,要获得高对比度的干涉条纹需要选择较大的入射角,但同时被测件倾斜方向的干涉图分辨率损失较为严重。因此,这种斜入射测量不适合测量未镀膜的光学平面。

实际测试SiC反射镜时,A,B均为未镀膜的光学平面,选择斜入射角α为45°,干涉图比例因子为0.35,此时干涉图反应的被测物的面形信息的本领较正入射测量时更强。干涉条纹沿被测件倾斜方向的压缩比为0.7,分辨率损失较小。采用移相算法计算斜入射测量的条纹对比度值为0.6。
4.4 精度验证实验
4.4.1 正入射情况下的检测实验
干涉仪正入射测量SiC反射镜的表面面形时,由于SiC反射镜的表面反射率很高,测试时形成的参考光和测试光光强不匹配,造成干涉条纹的对比度下降,如图9(a)所示。被测SiC反射镜的面形在600 mm口径内正入射测量结果为PV=0.079λ,RMS=0.009λ,如图9(b)所示。由此可见SiC反射镜的制造精度已经接近于干涉仪的空腔精度,正入射测量的结果受到参考面面形精度的限制,因此采用正入射测量无法精确给出被测SiC反射镜的面形分布。

4.4.2 斜入射情况下不同入射角的检测实验
大口径干涉仪斜入射测量SiC反射镜时,斜入射角的选取很受干涉仪平台尺寸大小的限制,因此本文采用口径100 mm的ZYGO GPI-XP型移相干涉仪进行了不同入射角下绝对检验结果的比对。此干涉仪的空腔精度PV值为0.031λ、RMS值为0.005λ(此处λ=632.8 nm),被测镜为100 mm口径的镀铝反射镜。分别选取入射角为30,45和60°按照文中实验方法对中心垂线进行斜入射绝对检验,结果如表2所示。由此可知,3个入射角下测量结果基本一致。
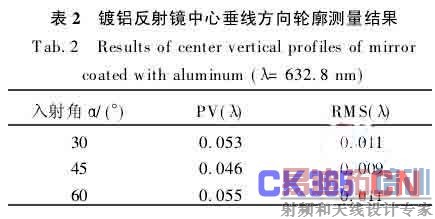
5 结 论
采用本课题组自行研制的大口径近红外相移平面干涉仪对630 mm口径的SiC平面反射镜进行了斜入射测量,中央垂线处的绝对检验结果PV值为0.061λ、RMS为0.014λ。该测量装置可以实现大口径光学平面垂线方向的绝对面形检测。测量过程中需要综合考虑空间分辨率、干涉图比例因子以及干涉条纹对比度等因素,选择合适的斜入射角度。该装置可以测试大于干涉仪有效口径的平面反射镜,尤其适合用于镀有高反膜的光学表面或者金属表面等面形的绝对测量。如果被测件的表面未镀膜时,可以通过增大斜入射角度的方法提高干涉条纹的对比度,同时需考虑空间分辨率的变化对测试结果造成的影响。要实现大口径平面镜其它方向的绝对检验需要旋转被测件,这将导致被测件自身应力发生改变进而引起面形变化,因此,如何实现整个平面的斜入射绝对检验是后续研究的主要方向。
参考文献:
[1] 王旭,张学军.固着磨料加工碳化硅反射镜的微观理论模型[J].光学精密工程,2009,17(3):513-518.
WANG X, ZHANG X J. Micro theoretical modelfor grinding SiC mirror with fixed abrasive [J].Opt. Precision Eng., 2009,17(3):513-518. (inChinese)
[2] 高明辉,刘磊,任建岳.空间相机反射镜碳化硅材料性能测试[J].光学精密工程,2007,15(8):1170-1174.
GAO M H, LIU L, REN J B. Characteristic test ofSiC for sPACe camera′s mirror[J].Opt. PrecisionEng.,2007,15(8):1170-1174. (in Chinese)
[3] 薛栋林,张忠玉,郑立功.大口径碳化硅材料凸非球面反射镜的检验[J].光学精密工程,2008,16(12):2491-2496.
XUE D L, ZHANG ZH Y, ZHENG L G. Testingmethods for large aperture convex SiC asphere mir-ror[J].Opt. Precision Eng., 2008,16(12):2491-2496. (in Chinese)
[4] PONCETTA J C, BEAVU V, DAURIOS J,et al..Metrology of large optical components for high powerlasers[J].SPIE,2003,4829:734-735.
[5] MALACARA D.Optical Shop Testing[M]. NewJersey: JohnWiley&Sons,2007.
[6] YELLOWHAIR J E.Advanced Technologies for Fab-rication and Testing of Large Flat Mirrors[D].Arizo-na: UNIversity of Arizona,2007.
[7] SEN H, NOVAK E, MIKE S. Application of ritchey-common test in large flat measurements[J].SPIE,2001,4399:131-136.
[8] SEN H, ZECCHINO M. Ritchey-common testingof large flats using a commercial interferometer[J].Applied Optics,1996,35(7):1015-1021.
[9] deGROOT P D. Diffractive grazing-incidence inter-ferometer[J].Applied optics,2000,39(10):1527-1530.
[10] EVANS C J, HOCKEN R J, ESLER W T. Self-calibration reversal, redundancy, error separation,and‘absolute testing’[J].ClRP Annals,1996,45(2):627-628.
[11] 徐德衍,王青,高志山,等.现行光学元件检测与国际标准[M].北京:科学出版社,2009.
XU D Y, WANG Q, GAO ZH S,et al.. CurrentOptical Components Testing and InternationalStandard[M].Beijing: Science Press,2009.
作者简介:
刘兆栋(1984-),男,江苏溧阳人,博士研究生,主要从事光干涉测量的研究。E-mail: liuzhaodong6 @ hotmail.com
韩志刚(1986-),男,江苏盐城人,博士研究生,主要从事光干涉测量的研究。E-mail:hannjust@163.com
严庆伟(1965-),男,江苏苏州人,高级工程师,主要从事光学制造工艺与检测的研究。E-mal: 5423563@ si-na.com
朱日宏(1964-),男,江苏盐城人,博士,教授,博士生导师,主要从事精密光学仪器理论与技术方面的研究。E-mail:zhurihong@vip.sina.com
导师简介:
陈 磊(1964-),男,江苏南京人,博士,教授,博士生导师,主要从事光学计量测试与光电智能化仪器方面的研究。E-mail: chenleiy@126.com


