- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
磁控溅射法沉积TCO薄膜的电源技术
1前言
透明导电氧化物薄膜(TCO薄膜)有着广泛的用途,如作为LCD、OLED显示器面板的电极,作为触摸屏的感应电极,作为薄膜太阳能电池的电极以及作为LED芯片前电极等[1]。
目前,主要的TCO薄膜有氧化铟锡(ITO)、氧化锡(SnO2)、氧化锌铝(AZO)三种[2],其中SnO2薄膜是最早应用的TCO薄膜,但由于其光电特性相对较差,目前主要应用在一些较低端的使用领域。ITO薄膜是目前光电特性最好,使用范围最广的TCO薄膜,但其同时存在使用稀有元素In,生产成本较高、In元素有毒、在氢等离子工艺氛围中性能退化等缺点。近年来,成本低、性能优良、无毒害的ZnO:Al(AZO)薄膜[3]得到了广泛的关注与研究,有希望替代ITO薄膜。
因此,ITO与AZO材料是当前研究和生产的最主要的TCO材料。
目前,产业界制备ITO、AZO薄膜主要是采用磁控溅射镀膜技术[4][5]。磁控溅射技术基于等离子技术,通常是在存在高电势差的靶(阴极)与阳极之间注入气体(一般为Ar气),通过等离子辉光放电实现对气体原子的离化,电场与磁场对离子加速和变向,进而轰击靶材表面,导致靶材原子被轰击到空间中,溅射在一块衬底材料上聚集形成薄膜[6]。
对于磁控溅射装置,磁控溅射电源决定了磁控溅射工艺过程等离子体状态,对镀膜工艺和膜层生长质量起着至关重要的作用[7]。随着生产和科技不断发展,用户对产品质量性能的要求越来越高。所以要求磁控溅射镀膜设备具有良好的可靠性、稳定性,有较高的镀膜效率和镀膜质量。
本文将主要描述磁控溅射ITO、AZO两大主要TCO薄膜的核心电源技术的发展现状、最新进展以及未来面临的挑战。
2磁控溅射TCO薄膜的电源技术发展概述
2.1磁控溅射直流电源
磁控溅射电源类型有直流电源、中频电源和射频电源。其中中频电源与射频电源成本较高,且沉积速率偏慢,尤其是射频电源沉积速率慢且由于驻波效应等,不适宜进行大面积镀膜,因此在制备大面积TCO薄膜技术领域应用较少。
TCO薄膜制备以直流磁控溅射技术为主。直流磁控电源简单可靠、工作稳定、功率大、沉积速率快。直流电源主要有恒流、恒压、恒功率等控制模式 以恒流磁控溅射直流电源系统为例,其基本原理如图1所示。电路由主电路部分和控制部分组成。电网输入单相交流电,通过工频整流,电感电容整流后为直流电。功率电子器件在控制电路的控制下将直流转换为脉冲交流电。经高频变压器,将交流脉冲升压。然后通过二极管整流和电感滤波输出直流。控制部分由PWM控制、IGBT驱动、恒流控制、过流保护等部分组成。

普通直流电源虽然已在在磁控溅射TCO薄膜生产中大量应用,但仍然存在很多缺点:
(1)TCO镀膜过程容易生成不导电物质,随着溅射过程中带电离子在不导电物质上的沉积,会形成弧光放电斑点[8]。尤其是AZO镀膜过程,弧光放电斑点时时刻刻大量存在,容易导致薄膜出现斑点、孔洞、变性等各种缺陷,导致膜层质量不高,生产良率低。
(2)由于电弧出现的频率与磁控溅射功率成正比,因此,限制了磁控溅射功率进一步的增大,即限制了镀膜生产速率进一步的提高。
(3)磁控溅射过程等离子密度低。被溅射物质的离化程度极低,导致晶格缺陷、高残余应力以及薄膜与衬底表面结合差[9]。
(4)由于被溅射物质离化程度低,被溅射物质只能直线运动,覆盖区域浅,无法对复杂构造物体表面全面镀膜,这一点远差于多弧离子镀技术,制约了磁控溅射技术的应用空间[10]。
2.2磁控溅射脉冲电源
磁控溅射脉冲电源的一个不可比拟的优点,是可以抑制溅射靶面的弧光放电。通过一定的频率输出脉冲电流,使镀膜过程绝缘层上积累的正电荷,在形成弧光放电条件之前被中和掉。
脉冲溅射技术实现的关键在于大功率脉冲电源[11]。为了在正半周内完全中和负半周中靶面绝缘层表面积累正电荷,脉冲电压必须具有一定的波形参数。Schiller等通过计算指出,脉冲电压的频率应为数10kHz[12]。进一步的大量实验研究表明,脉冲磁控溅射电源的脉冲频率设计在中频10kHz-200kHz时,可以有效防止靶材电弧放电及稳定反应溅射沉积工艺,实现高速沉积、高质量反应薄膜。
如图2所示,为一种脉冲电源系统的基本结构。主要包括三相整流及控制电路,逆变及控制电路,保护电路等。三相电源经整流电路整流后,变成脉动的直流电,然后由R、C网络滤波后送至全桥逆变器,在控制电路的控制下与LCC串联、并联电路谐振,输出变压器与并联电容相并联,并隔离驱动负载。

图2 磁控溅射脉冲电源原理示意图
虽然磁控溅射脉冲电源具备了灭弧的功能,能有效提升磁控溅射制备TCO薄膜的工艺质量,但其仍存在一些缺点:
(1)价格昂贵。稳定可靠的大功率脉冲电源造价昂贵,为普通直流电源一倍以上。
(2)维护成本高。
(3)无法解决传统磁控溅射过程等离子密度低,成膜质量一般,不具备复杂结构表面镀膜功能的问题。
针对这些问题,在最新的磁控溅射电源技术进展中逐步提出了解决方案。
3. 磁控溅射TCO电源最新技术
3.1具备快速灭弧补偿功能的直流电源
针对在TCO薄膜直流磁控溅射过程中(尤其是AZO镀膜)存在大量弧光放电现象的问题,为降低电源成本,一个新的重要发展方向是采用带快速灭弧功能的直流电源。
这种电源的最关键技术是3点:① 当弧光放电发生时能在早期迅速检测到做出合理判断。② 在识别出弧光放电情况后能迅速切断电源而灭掉电弧;③ 在切断电源后,恢复磁控放电。[p]
在此基础上,通过采用补偿技术,可进一步减少灭弧后残余能量的影响,精细优化镀膜质量。
目前主要有3种不同的电弧监测方法[13]:
(1)基于弧光放电电流探测的检测方法
在输出电流Iout超过用户设定电流阈值Ix时作出反应(图3)。侦测时间取决于设定的阈值,通常为300ns。关断时间大约为1.5μs。中断时间和恢复时间可以分别设定在0ms~80ms或者0ms~100ms。

图3 基于电流检测弧光放电的原理图
(2)基于弧光放电时的电压检测方法
当电压超过用户设定的阈值时监测器开始工作,电压低于用户设定的阈值时监测器触发。
(3)基于电压电流结合的检测方法
当输出电压低于用户设定的电压阈值而电流高于用户设定的电流阈值时监测器工作。
在快速检测和切断灭弧的系统基础上,电源具备灭弧补偿技术可进一步提升工艺的可靠性。这种技术的基本原理,是当电弧被检测到以及关断电源以后,给电源电缆施加一个正电压,使电缆上的负电压很快消失,可以进一步减小监测出电弧以后传送到溅射阴极上的剩余能量,优化镀膜质量。
如图4所示,为一种灭弧补偿装置的原理。在正常工作时,电容C被充电。发生电弧时,快速切换开关SS打开,电容对电缆施加一个正的电压。电源与阴极之间的感应能量可以通过公式E=(LI2)/2计算出来。假设电缆电感为每米L=1μH,那么对10m长的电缆和电流为I=100A的电弧,能量为50mJ。

图4 灭弧补偿装置原理示意图
增加补偿装置以后的电弧监测系统可以再实现快速关断的同时,显著减小电弧能量到1mJ/kW以下。
Dirk Ochs等人实验研究了采用补偿装置的电源在镀AZO薄膜过程的实际效用。如图5所示,在AZO溅射过程中的一次电弧发生时,电流从工艺中的10A上升到约30A。大约2μs后电源关断,电流下降。又过了7μs后电流下降到大约0A。具备补偿装置的电源其电流下降得更迅速。电流下降到零的时间不足1μs。这样显著减小了输送到电弧的能量,使其低于1mJ/kW。

图5 电弧发生时具备补偿装置(CL)及不具备补偿装置的电流波形对比
在同样的工艺下,Dirk Ochs[14]对具备灭弧补偿功能的直流电源和普通脉冲电源(脉冲电源的频率为50kHz,占空比为75%)进行了对比。在玻璃上沉积460nm厚的AZO膜层并检测其透光率。结果显示,对应两种工艺的透光率完全一样。两种样品都在真空下350℃退火15min,退火后,短波段下的透光率稍微上升,而长波段的透过率下降。同样,两种工艺下的结果一样。两种沉积工艺下的电阻率对比也显示了相似的结果。
因此,采用有效的快速电弧关断恢复技术的新型直流电源技术,相比脉冲直流电源技术性能相当,成本更低,具备广阔的发展空间。
这种技术的主要缺点是,仍然无法解决传统磁控溅射过程溅射物质离化率低,成膜质量一般,不具备复杂结构表面镀膜功能的弱点。此外,由于大功率化制造成本较高,可靠性较低,也制约了其大功率化发展。
3.2模块化磁控溅射电源
为了提高磁控溅射电源性能,同时降低成本、提高系统可靠性和降低设备的稼动率,业界采用了电源模块化的概念。电源系统可按单台20kw或30kw或其它功率值设计成一个模块。模块之间组合堆栈(主/从设计)。各模块机架可完全分离,便于用户以后的扩容或减容,使用非常方便,故障处理简单方便,有利于提高生产效率。
模块化技术的引入,进一步的推广了磁控溅射电源的应用。
3.3 HPPMS专用脉冲直流电源
上文介绍的各种磁控溅射电源虽然都有不少优点,但始终无法解决传统磁控溅射过程中溅射物质原子的离化率极低的弱点。
高功率脉冲磁控溅射技术(HPPMS)[15]是近年来新兴的重要发展方向,它通过HPPMS专用电源可以大幅提升溅射物质原子的离化率[16][17]。通过外加电场和磁场可大幅增强对溅射物质成膜工艺过程的精确控制,可以制备更加精细可靠的薄膜,可以实现更复杂结构外表的全方位可控镀膜,同时,充分有效的离子轰击衬底,可实现低温镀膜,实现在塑料柔性衬底材料镀膜。
在这一领域,Kouznetsov等[15]率先取得重要突破,他通过实验证实在Cu的溅射过程中引入这种高脉冲电流,获得了比传统直流溅射高两个数量级的离子密度,其溅射物质离化率高达70%。离子流大小比传统磁控溅射高2-3个数量级,改善效果十分明显,具有革命性的意义。
实现HPPMS技术的关键之一在于电源,其必须可以提供高功率密度的脉冲波(通常为几kW/cm2左右),同时保证施加在靶上的平均功率密度与传统直流磁控溅射相当(几W/cm2左右)[18],以防止阴极过热导致靶材、磁铁、靶体过热损坏。目前,一些研究机构和公司已经研制出各种HPPMS电源装置,应用在实验室及生产线上,这些装置的基本结构原理相似,如图6所示。一台直流电源用以给脉冲发生部分的电容器组充电,脉冲发生部分与磁控溅射阴极直接连接。电容器组的充电电压从几100V到几1000V不等。脉冲发生部分通过斩波电路将直流电压、电流变换成频率和脉宽均可调的脉冲电压和电流。斩波电路使用IGBT模块,将IGBT作为开关串联在直流回路中,通过触发脉冲控制半导体开关的通断,进而控制了脉冲电压的输出。

图6 HPPMS电源的基本架构图[p]
Kouznetsov等人研究表明,输出脉冲的脉宽在5ms -5000ms,频率在10Hz-10kHz范围时,靶的电流密度峰值可达到数A/cm2量级,比传统直流磁控溅射电流密度高3个数量级。进而实现70%以上的极高离化率[15]。
在HPPMS放电期间产生的高能峰值电流,会加大弧光放电出现的频率[19]。因此,很多研究采用在HPPMS电源上增加复杂的弧光放电,控制电子系统以控制弧光放电现象。另一种解决方法,是HPPMS电源输出脉宽5ms -20ms的短脉冲,实现对弧光放电现象的抑制[20]。这种操作模式的波形如图7所示,在这短暂的时间内,辉光放电从短暂的不稳定状态恢复正常[21](如图7中靶放电电流所示)。因此,辉光放电向弧光放电的转变被有效制止。这种短脉冲保证了进行金属氧化物薄膜反应溅射镀膜时放电过程无弧光放电问题。
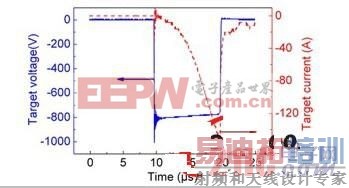
图7 在HPPMS电源中采用短脉冲抑制弧光放电过程的电流变化
在磁控溅射TCO薄膜时(AZO、ITO)采用HPPMS技术,展现了非常积极的效果。Sittinger V等人的研究表明[22],采用HPPMS技术制备的TCO薄膜拥有更加优良的电性能和表面光洁度。除此以外,也可实现在低温下沉积性能优良的TCO薄膜,这使得采用磁控溅射技术在PI膜等柔性材料上制备高质量TCO薄膜成为可能。
尽管HPPMS技术虽然有着很多好处,但是其电源的研制仍然面对许多挑战:
(1)目前HPPMS电源仍主要是局限于实验室小型磁控溅射设备的应用,在大面积镀膜的工业化领域应用技术仍不成熟。比如针对大型工业化设备的弧光放电现象,一方面增加了检测电路控制系统的复杂性和不可靠性,同时由于需要HPPMS电源在数ms的时间内关断MW功率工作机组,增大了系统风险,目前这样的系统可靠性仍不高。
(2)HPPMS技术生长薄膜速度比传统磁控溅射技术慢。HPPMS的优点是产生了极高的溅射物质离化,但同时由于高电压的应用,部分离化的离子会被靶上的高负电势吸回,导致生长速率偏慢。
(3)高功率脉冲电源成本高,远高于普通直流电源。由于材料成本及技术不成熟所限制,现在HPPMS电源制造成本高,制约了其在产业界的应用。
4 结语
随着平板显示产业、太阳能产业、LED产业、建筑玻璃行业、触摸屏行业的迅猛发展,TCO镀膜产业迎来了新一轮发展。磁控溅射技术是最主要的TCO镀膜技术,磁控溅射电源作为其中的核心部件,对于TCO镀膜产业的发展具有至关重要的作用。
随着对TCO薄膜产品的性能要求的日益提高。传统的直流磁控溅射电源正逐步被具备优良灭弧性能的脉冲直流电源取代,与此同时更经济的具备优良灭弧功能的新型直流电源也逐步进入商业化应用。而许多研究机构和大公司已开始研发代表新一代磁控溅射技术发展方向的HPPMS电源。
目前,国内仅实现普通磁控溅射直流电源的国产化,在其它技术方面国内仍严重落后于国际先进水平,市场基本被国际大厂垄断。随着新型电源技术的出现,磁控溅射电源技术正处于发展新技术的更新换代时期。国内电源厂商和技术人员需要抓住市场发展的机遇,努力研发,开创新的发展局面。
参考文献
[1] 徐美君. ITO 透明导电膜玻璃生产及应用[J]. 玻璃与搪瓷,2001, 29(2):53~59.
[2] H. Glaser. 大面积玻璃镀膜[M].上海:上海交通大学出版社,2006.117~119.
[3] 刘玉萍,陈枫.AZO透明导电薄膜的制备技术及应用进展[J]. 真空与低温,2007,13(1):1~5.
[4] 陶海华,姚宁,辛荣生. ITO 透明导电薄膜的制备及光电特性研究[J]. 郑州大学学报(理学版),2003,35(4):37~40.
[5] 徐成海,陆峰,谢元华.氧化锌铝透明导电膜[J].真空电子技术,2003,(6):39~44.
[6] 徐万劲.磁控溅射技术进展及应用(上)[J].现代仪器,2005,(5):1~5.
[7] Brauer G., Szyszka B, Vergohl M. Magnetron sputtering-Milestones of 30 year[J]. Vacuum,2010,84:1354–1359.
[8] Takikawa H, Tanoue H. Review of cathodic arc deposition for preparing droplet-free thin films [J]. Plasma Science, IEEE Transactions on, 2007, 35(4): 992~999.
[9] Christou C, Barber Z.H. Ionization of sputtered material in a planar
magnetron discharge [J]. Journal of Vacuum Science Technology A, 2000, 18(6): 2897~2908.
[10] Helmersson U, Lattemann M, Bohlmark J, et al. Ionized physical vapor deposition
(IPVD): A review of technology and applications [J]. Thin Solid Films, 2006, 513(1):1~24.
[11] 陈侃松,顾豪爽,孙奉娄等.一种新型的中频交流等离子体电源[J].电路与系统学报.2006, 1l(4):78~81.
[12] 陈文光.脉冲溅射电源设计[J].机械加工与自动化,2004,(4):8~11.
[13] Ochs D, Rettich T. SVC 51th Annual Technical Conference Proceedings SVC (2008).
[14] Ochs D. New Features of DC Power Supplies for TCO Magnetron Sputtering [J]. OTTI Thin
Films Photovoltaic Conference 2009.
[15] Kouznetsov V, Macak K, Schneider J.M, et al. A novel pulsed magnetron sputter techni
queutilizing very high target power densities [J]. Surface and coatings technology, 1999, 1222):
290~293.
[16] Bugaev S.P, Koval N.N, Sochugov N.S, et al. Investigation of a highcurrent pulsed
magnetron discharge initiated in the low-pressure diffuse arc plasm
[J]. XVIIth International Symposium on Discharges and Electrical Insulation in Vacuum, 1996,
2:1074~1076.
[17] Fetisov I.K, Filippov A.A, Khodachenko G.V. Impulse irradiation plasma technology for
filmdeposition [J]. Vacuum, 1999, 53(1):133~136.[p]
[18] Helmersson U, Lattemann M, Bohlmark J. Ionized physical vapor deposition (IPVD):
A review of technology and applications [J]. Thin Solid Films, 2006, 513(1):1~24.
[19] Christie D.J, Tomasel F., Sproul W.D. Power supply with arc handling for
high peak power magnetron sputtering [J].Journal of Vacuum Science Technology A: Vacuum,
Surfaces, and Films, 2004, 22(4):1415~1420.
[20] Ganciu M, Konstantinidis S, Paint Y. Preionised pulsed magnetron discharges for
ionised physical vapour deposition [J]. Journal of Optoelectronics and Advanced Materials,
2005, 7(5):2481~2484.
[21] Musil J, Lestina J, Vlcek J. Pulsed dc magnetron discharge for highrate sputtering
of thin films [J]. Journal of Vacuum Science Technology A: Vacuum, Surfaces, and Films,
2001, 19(2): 420~424.
[22] Sittinger V, Ruske F, Werner W. High power pulsed magnetron sputtering of transparent
conducting oxides [J]. Thin Solid Films, 2008, 516(17): 5847~5859.■
射频工程师养成培训教程套装,助您快速成为一名优秀射频工程师...

