- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
FlipFET MOSFET非常适合于对空间敏感的负载管理应用
由于消费者要求产品具有更多的功能和更长的电池寿命,同时产品外形必须不断缩小,所以业界越来越需要更新和更好的负载开关技术。芯片设计和制造已经取得巨大进步,相形之下,封装就成为改善器件特性的一个主要局限。在一个功率MOSFET器件中,现有的封装技术通常要对其多达30%的导通电阻(RDson)负有责任。负载开关要求非常低的导通电阻,以便将传导功率损耗降至最小。此外,为了适应手持式应用不断缩小的外形,减少现有封装的占位面积正变得非常必要,与此同时还不能牺牲其目前承载硅片的能力。这些挑战促使国际整流器公司(IR) 开发了新的FlipFET封装技术。FlipFET技术是一种真正的芯片级封装(CSP)技术,它实现了新一代的超紧凑功率架构,而且在者业界首次获得了100%的硅片/占位面积比。
开发了新的FlipFET封装技术。FlipFET技术是一种真正的芯片级封装(CSP)技术,它实现了新一代的超紧凑功率架构,而且在者业界首次获得了100%的硅片/占位面积比。
在这种新型专有封装中,裸片本身就是封装。因此,漏电感以及其它与器件封装有关的损耗被降至最小或被消除, 同时热阻也得到了改善。通过采用新的FlipFET封装,占位面积将减少70%以上,不及流行的TSOP-6封装的1/3,同时可提供相同或更好的性能。采用这种新封装的任何一款IR低电压HEXFET 功率MOSFET都可提供在业界中每单位占位面积最低的RDson,因此非常适合于各种对空间敏感的负载管理应用。
本文将介绍FlipFET器件,并探讨它们与现有封装相比的优点。我们还将讨论我们在设计中的一些考虑事项,以及与大批量可制造性相关的问题。我们还将考察两款为负载管理应用而优化的新型IRF6100和IRF6150 P通道FlipFET MOSFET。
什么是FlipFET封装?
IR的FlipFET技术利用了真正的芯片级封装:其裸片被钝化和“凸起”以生成互连。“免封装”的这项技术实现了硅片/裸片占位面积比达到100%的最终目标。由于省去了引线框架(lead frame)和塑料模具,因此消除了与封装有关的电阻和电感损耗,从而对于给定的RDson可允许小得多的器件占位面积。裸片有源区域的钝化是通过在制造期间沉淀一个钝化层来实现的,它相当于最后的一道掩模工艺。这可保护裸片免受湿气、灰尘等外部因素的影响。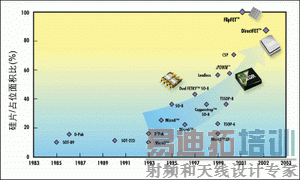
与其它现有的功率MOSFET不同,FlipFET器件中的栅极、漏极和源极都被置于裸片的同一个面上。这使得器件的所有连接“凸起” 都可以在同一个面上,从而实现了100%的裸片/占位面积比。图1展示了一个FlipFET器件。
FlipFET器件还表现出改善的散热性能,从而允许设计者规划比标准小外形封装器件可能达到的更高功率密度。
FlipFET封装与现有封装的比较
对于低功率便携式应用, TSOP-6和SOT-23为表面贴装技术(SMT)提供的功率MOSFET封装直到最近仍是最佳的功率密度解决方案,但人们不断要求甚至更高的密度。
能很好地反映功率密度的一个指标是硅片/占位面积比。它是指用封装中的硅片(裸片)除以总占位面积所得的比率。图2显示了封装的发展历程,以及它们的硅片/占位面积比。我们从此图中可以看出,FlipFET是最新加入的成员,并且比现有封装显著改善了硅片/占位面积比。SOT-23的硅片/占位面积比约为18%,TSOP-6的约为22%。
衡量封装产品性能的另一种方法可以用空间品质因数(FOM)来表示,它是器件RDson与占位面积的乘积。图3给出了各种不同封装之间FOM的比较。
BGA 封装技术很实用,因为板与封装之间的互连位于封装的底部。因此,采用BGA封装时,占位面积被减少为封装的外型。这种器件还提供了改善的空间FOM(比TSOP-6减少了53%),以及50%左右的硅片/占位面积比。BGA技术的总结是:焊球应被直接置于,或邦定在裸片上而不是在封装的底部。FlipFET器件的空间FOM比TSOP-6约节约了77%,如图3所示。
图4显示了FlipFET器件与TSOP-6和SO-8封装的视觉对比效果。
大批量可制造性
FlipFET适合于安装在陶瓷板和有机板上。焊接掩模和无焊接掩模定义的衬垫都能使用,它们的直径应为250微米。
表面涂层可以是通常用于SMT的几乎任何材料。许多评估测试已经成功地在非电镀镍/金板上进行。浸银或浸锡等涂层以及各种有机的表面防腐剂也将适用。我们不推荐热气平焊,因为它会在衬垫上产生不同的焊接量。这将导致裸片倾斜,从而降低可靠性。
从FlipFET器件到PCB的热路径非常短,因此它成为器件散热的首要方向。由于省去了塑料封装,从连接点到PCB的热阻(RthJ-PCB)被降低到了35℃/W(典型值)。在设计印制电路板时,势必要考虑组装的散热要求。例如,连接到更大的地平面将能提供比窄走线好得多的热路径。
IRF6100和IRF6150 FlipFET MOSFET
FlipFET封装已被用于两种采用P沟道配置的MOSFET器件。IRF6100是一个20伏的P沟道器件,IRF6150是一个双20伏的P沟道器件。表1列出了器件的部分关键特性。
FlipFET设计是基于IR的低电压、极低RDson的单元沟技术。这种极高通道密度的设计在每平方英寸上包含了超过110x106个单元,它已被成功用于众多的P沟道和N沟道、超低RDson基准的产品中,这些产品面向便携式、笔记本电脑和汽车应用。FlipFET设计与传统的沟结构之间的主要差别是,它采用专有工艺将漏极从裸片的背面转到了前面。
这些产品的典型应用包括在蜂窝电话和笔记本电脑中的电池充电和负载开关电路。不过,FlipFET封装可以用于其它HEXFET硅平台,从而为具有不同关键参数(如雪崩能力或开关速度)的各种应用制造优化的产品。IRF6100可提供与SO-8 MOSFET器件相同的RDson,而所占空间仅为后者的1/3。
总结
蜂窝电话、PDA、笔记本电脑和智能型电池组的尺寸正变得越来越小,而消费者要求越来越长的电池寿命,以便不间断地使用这些产品。与此同时,这些设备的外形正在不断缩小。这些因素共同向创建功率管理电路的设计者提出了巨大的挑战。IR的FlipFET功率MOSFET为设计者提供了显著的优势。采用新的FlipFET封装,占位面积将减少70%以上,不足流行的TSOP-6和SO-8封装的1/3。IR的FlipFET利用了彻底“免封装”的真正芯片级封装技术,从而使总的RDSon比采用标准封装的同类器件减少了多达30%。
IRF6100和IRF6150是P沟道MOSFET,已经针对极低RDson进行了优化,这使它们适合于负载管理和电池充电等应用。
作者:Dan Kinzer
产品研发与工程部副总裁
Tim Sammon
封装研发部总监
国际整流器公司
射频工程师养成培训教程套装,助您快速成为一名优秀射频工程师...
天线设计工程师培训课程套装,资深专家授课,让天线设计不再难...
上一篇:构建高性能ADSL前端电路
下一篇:双极型晶体管和MOSFET在电源开关中的应用

