- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
PCBA大讲堂:BGA枕头效应(head-in-pillow)发生的可能原因
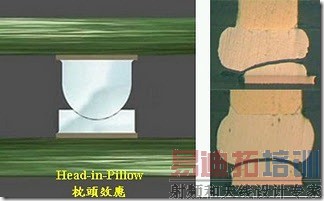
枕头效应(Head-in-Pillow,HIP)是指焊点的不良现象类似一个人的头靠在枕头上的形状而得名。
枕头效应(Head-in-Pillow,HIP)最主要是用来描述电路板的BGA零件在回焊(Reflow)的高温过程中,BGA载板或是电路板因为受不了高温而发生板弯、板翘(warpage)或是其他原因变形,使得BGA的锡球(ball)与印刷在电路板上的锡膏分离,当电路板经过高温回焊区后温度渐渐下降冷却,这时IC载板与电路板的变形量也慢慢回复到变形前的状况(有时候会回不去),但这时的温度早已低于锡球与锡膏的熔锡温度了,也就是说锡球与锡膏早就已经从熔融状态再度凝结回固态。当BGA的载板与电路板的翘曲慢慢恢复回到变形前的形状时,已经变回固态的锡球与锡膏才又再次互相接触,于是便形成类似一颗头靠在枕头上的虚焊或假焊的焊接形状。
HIP(Head-In-Pillow)检测
按照上面的理论,枕头效应(HIP)大部分应该都会发生在BGA零件的边缘,尤其是角落的位置,因为那里的翘曲最严重,如果是这样,就可以试著使用显微镜或是光纤内视镜来观察,但通常这样只能看到最外面的两排锡球,再往内就很难辨认了,而且这样观察BGA的锡球还得确保其旁边没有高零件挡住视线,以现在电路板的高密度设计,执行起来限制颇多。
另外,枕头效应(HIP)一般也很难从现在的2D X-Ray检查机发现得到,因为X-Ray大多只能由上往下检查,看不出来断头的位置,如果有可以有上下旋转角度的X-Ray应该就可以观察。有些时候或许可以经由板内测试(ICT, In Circuit Test)及功能测试(FVT, Function Verification Test)检测出来,因为这类机器通常使用针床的作业方式,需要添加额外的外界压力于电路板上,让原本互相挨著的锡球与锡膏有机会分开,但还是会有许多的不良品流到市场,通常这类不良品很快的就会被客户发现有功能上的问题而遭到退货,所以如何防治枕头效应的发生实为SMT的重要课题。
另外,也可以考虑透过烧机(Burn/In)的方式来筛选出有HIP的板子(如果单板烧机要加温度),因为烧机的时候会有升高板子的温度,温度会让板子变形,板子有变形,空/假焊的焊点就有机会浮现出来,所以烧机的时候还得加上程式作自我诊断测试,如果HIP的位置不在程式测试的线路上,就查不出来了。
目前比较可靠可以分析HIP不良现象的方法是使用染红试验(Red Dye Penetration),以及微切片分析(Cross Section),但这两种方法都属于破坏性检测,所以非到必要不建议使用。
新近【3D X-Ray CT】的技术有了突破,可以有效的检查到这类HIP或是NWO(Non-Wet-Open)焊接缺点,而且也慢慢普及了起来,但机台的费用还是不够便宜就是了。
HIP的发生的可能原因
枕头效应虽然是在回流焊期间所发生的,但其真正形成枕头效应的原因则可以追溯到材料不良,而在电路板组装工厂端则可以追溯到锡膏的印刷,贴件/贴片的淮确度及迴焊炉的温度设定…等。
底下是几个形成枕头效应(HIP)缺点的可能原因:
1、BGA封装(Package)
如果同一个BGA的封装有大小不一的焊球(solder ball)存在,较小的锡球就容易出现枕头效应的缺点。
另外BGA封装的载板耐温不足时也容易在回流焊的时候发生载板翘曲变形的问题,进而形成枕头效应。
(warpage of substrate, inconsistent bump size)

2、锡膏印刷(Solder paste printing)
锡膏印刷于焊垫上面的锡膏量多寡不一,或是电路板上有所谓的导通孔在垫(Vias-in-pad),就会造成锡膏无法接触到焊球的可能性,并形成枕头效应。
另外如果锡膏印刷偏离电路板的焊垫太远、错位,这通常发生在多拼板的时候,当锡膏熔融时将无法提供足够的焊锡形成桥接,就会有机会造成枕头效应。
(insufficient solder paste volume, printing misalignment)
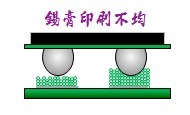

3、贴片机的精度不足(Pick&Place)
贴片机如果精度不足或是置件时XY位置及角度没有调好,也会发生BGA的焊球与焊垫错位的问题。
另外,贴片机放置IC零件于电路板上时都会稍微下压一定的Z轴距离,以确保BGA的焊球与电路板焊垫上的锡膏有效接触,这样在经过回流焊时才能确保BGA焊球完美的焊接在电路板的焊垫。如果这个Z轴下压的力量或形成不足,也有机会让部份焊球无法接触到锡膏,而造成HIP的机会。
(Inaccurate XY placement, insufficient placement force)


4、回流焊温度(Reflow profile)
当回流焊(reflow)的温度或升温速度没有设好时,就容易发生没有融锡或是发生电路板及BGA载板板弯或板翘…等问题,这些都会形成HIP。可以参考BGA同时空焊及短路可能的原因一文,瞭解BGA载板与电路板因为CTE的差异过大,以及TAL(Time Above Liquids)过长,而造成的板弯板翘所形成的BGA空焊及短路的分析。
另外,要注意预热区的温度升温如果太快的话容易驱使助焊剂过早挥发,这样就容易形成焊锡氧化,造成润湿不良。其次最高温度(Peak Temperature)也最好不要调得过高及过久,建议最好参考一下零件的温度及时间的建议。
(inadequate reflow profile that results in component & PCB warpage, Lifting of BGA bumps due to wetting force, Excessive Peak Temperature, too much TAL)

5、焊球氧化(Solder ball Oxidization)
BGA在IC封装厂完成后都会使用探针来接触焊球作功能测试,如果探针的洁淨渡没有处理的很好,有机会将污染物沾污于BGA的焊球而形成焊接不良。其次,如果BGA封装未被妥善存放于温湿度管控的环境内,也很有机会让焊球氧化至影响焊锡的接合性。
射频工程师养成培训教程套装,助您快速成为一名优秀射频工程师...
天线设计工程师培训课程套装,资深专家授课,让天线设计不再难...
上一篇:SMT大讲堂:设计Thermal
Relief
pad(热阻焊垫/限热焊垫)降低焊接不良
下一篇:PCBA大讲堂:低温锡膏制作HotBar焊接的可行性评估

