- 易迪拓培训,专注于微波、射频、天线设计工程师的培养
BGA焊点空洞的形成与防止技术
BGA空洞(图1、图2)会引起电流密集效应,降低焊点的机械强度。因此,从可靠性角度考虑,应减少或降低空洞。那么,如何可以降低BGA空洞?要回答这个问题,我们有必要探索一下空洞的形成原因。
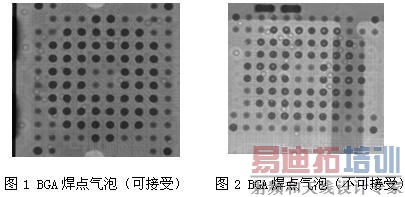
BGA空洞的形成原因有多方面,如:焊点合金的晶体结构、PCB板的设计、印刷时,助焊膏的沉积量、所使用的回流焊工艺等、焊球在制作过程中夹杂的空洞。
下面我们从助焊膏的层面对GBA焊点空洞的形成与防止作一些阐述,以期减少BGA焊点空洞的形成数量。
1 炉温曲线设置不当
1) 表现在在升温段,温度上梯度设置过高,造成快速逸出的气体将BGA掀离焊盘;2)升温段的持续时间不够长,当升温度结束时,本应挥发的气体还未完全逸出,这部分的气体在回流阶段继续逸出,影响助焊体系在回流阶段发挥作用。
2 助焊膏溶剂搭配不当
表现在,1)在升温阶段,快速逸出的气体将BGA 撑起,造成错位与隔阂;2)在回流阶段,仍有相当数量的气体从助焊膏体系中逸出,但受限于BGA与焊盘间的狭小空间,这些挥发气体无法顺畅地通过这个空间逸出,致使其挤压熔融的焊点。
3 助焊膏润湿焊盘的能力不足
助焊膏对焊盘的润湿表现在它对焊盘的清洁作用。因助焊膏润湿能力不足,无法将焊盘上的氧化层去除,或去除效果不理想,而造成虚焊。
助焊膏对BGA焊球的润湿能力不足:与助焊膏对焊盘的润湿能力不足相似,只不过,因焊球的合金类型不同,BGA上的氧化物的电动势也就不同,这样就要求助焊膏具备适应去除不同合金类型的氧化物的能力,若不匹配,则造成对BGA焊球的润湿能力不足,导致空洞。
4 回流阶段助焊膏体系的表面张力过高
主要是所用的载体(主要是松香)选择不当,此外表面活性剂的选择也有关系。我们在实验过程中发现,某些活性剂不仅可以降低助焊膏体系的表面张力,也可显著降低熔融合金的表面张力。松香与表面活性剂的有效配合可使润湿性能充分发挥。
5 助焊膏体系的不挥发物含量偏高
不挥发物含量偏高导致BGA焊球的熔化塌陷过程中BGA下沉受阻,造成不挥发物侵蚀焊点或焊点包裹不挥发物。
6 载体松香的选用
相对于普通锡膏体系选用具有较高软化点的松香而言,对BGA助焊膏,由于其不需要为锡膏体系提供一个所谓的抗坍塌能力(即在锡膏印刷后直到锡膏熔化这个过程中,印刷图形完整性的保持能力),选择具有低软化点的松香具有重要的意义。
7 松香的使用量
与锡膏体系不同,对BGA助焊膏而言,松香的使用是为各种活性剂提供载体的作用,使这些物质在适当的时机释放出来,发挥其作用。然而,过多的松香不仅阻碍这些物质的释放,松香本身由于其量多,当BGA焊球塌陷(即BGA焊球与其上下的焊盘发生熔焊的这个过程)时,它却会阻碍BGA焊球的塌陷,从而造成空洞。
故,松香的使用量应比锡膏体系中松香的使用量低得多。
造成BGA空洞的另一个原因是焊接过程中的返浸润现象。这种现象的形成与助焊膏体系中的活性物质的作用温度与作用的持续时间有关。在BGA回流焊接过程中,受重力的影响,BGA焊盘比SMT锡膏焊接更易出现这种不良现象。
在意识到这些影响因素之后,我们在研发过程中增加了相应的检测措施,如我们引入了热重分析仪,对拟采用的材料、制作出来的助焊膏进行热学分析,直观了解这些热学特性,并检验设计设想与实际表现间存在的差异,采取措施加以克服,以最终满足使用工艺要求;以及开展表面张力的测量工作。在不同温度下,通过对助焊膏体系及其影响对象的表面张力的测量,最终确定合适的表面张力范围。
以上就助焊膏引起BGA空洞的原因进行列举与探讨。与锡膏的研发类似,BGA助焊膏的研发也是一个平衡各种影响因素的过程。虽然各个因素有个独特的作用,但就整个体系而言,它们之间又是彼此相互作用。找到各种影响因素有助于问题的解决,而寻找解决方案,特别是找到合适的材料才是最终的法宝。
射频工程师养成培训教程套装,助您快速成为一名优秀射频工程师...

